Implantacja jonów
Implantacja jonów jest procesem z dziedziny inżynierii materiałowej w którym jony materiału są rozpędzane i zderzane (implantowane) z podłożem, powodując zmianę jego właściwości fizycznych. Implantacja jonów stosowana jest w produkcji elementów półprzewodnikowych, wykończaniu metali oraz badaniach materiałowych. Wprowadzane jony powodują zarówno zmiany chemiczne (implantować można dowolny pierwiastek w dowolny materiał) jaki i strukturalne (niszczenie struktury krystalicznej). Implantowanie jonów może być realizowane w stosunkowo niskich temperaturach, skutki uboczne w postaci zniszczenia struktury krystalicznej są usuwane poprzez wygrzewanie w podwyższonej temperaturze. Proces implantacji można w praktyce całkowicie zautomatyzować, przy zachowaniu wysokiej powtarzalności właściwości nowych wyrobów.
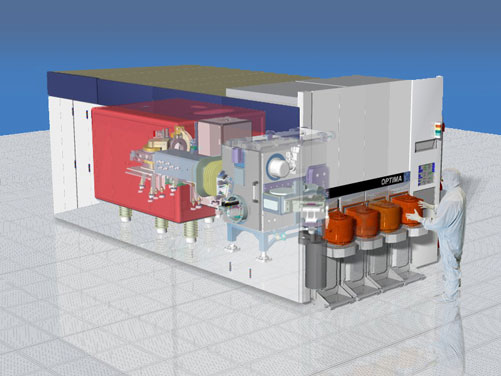
Zastosowania implantacji jonów:
- modyfikacja diód, tranzystorów, układów i czujników półprzewodnikowych
- wytwarzanie nowych rodzajów stopów metali o zwiększonej trwałości termoodporności i odporności na korozję
- podwyższanie twardości i pasywacja lub aktywacja powierzchni metali
- polerowanie i wygładzanie powierzchni soczewek optycznych
Implantatory jonów
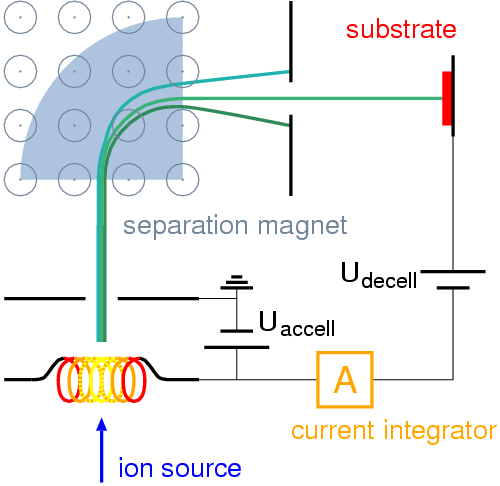
Urządzenia do implantacji jonów zbudowane są z
- źródła jonów, w którym wytwarzane są pożądane jony
- akceleratora – najczęściej liniowe akcelerator elektrostatycznego lub wielkiej częstotliwości, który przyspiesza jony do energii wymaganej przez proces technologiczny,
- magnetycznego separatora jonów, który z przyspieszonej wiązki wydziela jony o odpowiedniej energii,
- komory w której znajduje się płytka półprzewodnika lub inny materiał podłożowy.
Zazwyczaj przyspieszane są pojedyncze atom, więc ilość implantowanej domieszki (doza) określana jest jako całka z prądu jonowego płynącego przez układ. Prądy te są stosunkowo małe, rzędu mikroamper, więc dozy implantowane w trakcie procesu są małe. Dlatego implantacja jonów znajduje zastosowanie w sytuacjach gdy wymagane są niewielkie modyfikacje podłoża.
Stosowane w mikroelektronice energie implantowanych ją są w granicach 10-500keV. Mniejsze energie (1-10keV) używane są do wytwarzania bardzo cienkich warstw, rzędu nanometrów. Wyższe energie do 5MeV w przypadku półprzewodników stosowane są rzadko gdyż powodują duże zniszczenia sieci krystalicznej. Także rozkład statystyczny w głąb materiału jest szeroki do uzyskiwane koncentracje domieszek są niewielkie.
O głębokości i rozkładzie domieszek w materiale podłoża decyduje energia bombardujących jonów. Rozkład domieszek implantowanych przy stałej energii jonów posiada na pewnej głębokości maksimum, a przed nim i za nim koncentracje są mniejsze. Dlatego aby uzyskać równomierny rozkład w trakcie implantacji zmieniana jest energia jonów docierających do materiału.
